




拥抱未来新机遇,香港科技大学3D IC与异构集成国际研讨会成功召开
2022-05-05 作者:HKUST
本文来源于:香港科技大学
目前大部分芯片厂商都感觉到遵循摩尔定律之途愈来愈难以为继时,业界一直努力在芯片中以实现更大更复杂的系统来满足市场需求。然而,将如此巨大规模的系统在单一的半导体芯片上实现是非常困难的,整个半导体产业目前也仍在为这种必须跨越工具、制程、设计端并加以整合的技术类别思考适合的解决方案。其中3D IC和异构集成技术能够将来自不同制造者的部件构建在一个芯片系统中,从而解决上述问题,成为了相关产业寻求持续发展的出路之一。为此,香港科技大学(HKUST)于2022年4月26日至28日在线举办为期3天的《3D IC与异构集成国际研讨会》(International Symposium on 3D IC and Heterogeneous Integration),研讨会云集顶尖大学和世界领先企业的科技精英,通过12场讲座和2场小组讨论,分享他们对异构技术最新趋势、机遇和挑战的看法,以期加强国际间的学术交流。

详情请扫描二维码
4月28日举办了第三场讲座“系统级封装和异构集成 ”,主持人香港科技大学教授Ricky Lee致词并对与会大咖进行了简单介绍。李教授提到,当前中国将芯片产业提高到了国家战略层面,而粤港澳大湾区更是提出将湾区建立成世界一流的通讯和电子科技产业集群的目标,其中对人工智能发展进行顶层设计,大湾区内部开放数据服务人工智能研究和芯片产业化。放眼全球,世界各地的顶尖团队均深耕于此,形成相互竞争、合作的良性关系,这为相关技术的研讨提供了更大空间、更多机会加强合作交流。香港科技大学一直从事相关的技术研究,并期望业内精英继续在这方面紧密合作,互相借鉴学习。

首先,来自乔治亚理工学院的教授Madhavan Swaminathan教授分享了课题“供电和散热-两个挑战可能成为人工智能应用的致命弱点”,他认为异构集成 (HI)技术为具有先进技术节点的小体积芯片之间的密集连接提供了可能,不但提高产品产量,而且实现缩短产品上市所耗时间,达到单个平台上不同芯片的连接以增强功能的目的。但人工智能 (AI) 中的新兴应用和普遍的连接性,对电力输送要求变得越来越高,导致相匹配的热管理解决方案也变得越来越具有挑战性。Madhavan Swaminathan教授认为,AI深度学习需要完全充足的计算能力,目前主流技术是通过扩展数据中心计算能力来实现,这将是不可持续的,需要采用必要的综合电力输送和热管理解决方案来应对,现在是需要我们重新考虑如何实现大规模高能源效率的方法,这也是一个更绿色的星球所必需的。

接下来,来自TechSearch International, Inc. 总裁兼创始人E. Jan Vardaman分享了课题“异构集成与 3D IC 的机遇与挑战”,E. Jan Vardaman探讨了新兴 3D IC 的优势,并解释了与过去产品和当前演示产品的不同之处,讨论了异构集成和 3D IC 的挑战,例如设计、测试、组装和散热等。同时详细阐述了当前主流的索尼公司、美光、三星、英特尔等公司的工艺流程,系统分析了三维集成电路的利弊。E. Jan Vardaman认为,随着行业进入异构集成的新时代,以小芯片和 3D IC 形式的先进封装变得越来越重要。过去曾提出 3D IC,已用于 CMOS 图像传感器和 HBM的生产,而现在新的 3D IC 也将会在年内实现量产出货,它已经不是原来带有微凸块的方案,而是采用更先进的带有直接混合键合的新方案。

随后,来自英特尔公司的博士Beth Keser提出未来是扇出的,Beth Keser认为近期包括高性能计算 (HPC)、自动驾驶辅助系统 (ADAS) 和汽车、5G/6G、物联网 (IoT)/MEMS/传感器在内的多个应用领域需要结合芯片来创建具有竞争力和可靠性的新产品解决方案。这些应用,无论是受性能、外形尺寸还是成本驱动,都需要封装解决方案,其中可以将截然不同的芯片集成到封装或系统中。Beth Keser探讨了这些不断增长的应用空间的当前和未来挑战、应对这些挑战所需的未来电子封装技术以及成功所需的技能。此外HPC、ADAS、5G/6G、loT将推动半导体封装市场提供高密度解决方案,这些解决方案包括分解芯片的异构集成。Beth Keser认为,针对一个市场开发的Hl技术解决方案可能会被另一个市场利用,而大学、研究所和联盟必须有一个良好的基础来解决这些即将到来的挑战。

第四位演讲嘉宾,来自Unimicron Technology Corporation的博士John Lau阐述了小芯片设计和异构集成封装的定义,并介绍了 Xilinx、AMD、Nvidia、Intel、TSMC 和三星等提供的小芯片设计和异构集成封装技术,展示了小芯片之间的横向通信,例如嵌入在有机积层封装基板中的硅桥和扇出环氧树脂模塑料以及柔性桥。简要介绍热压键合和混合键合等关键使能技术。并就小芯片设计和异构集成封装的趋势和挑战(机遇)进行讨论,John Lau博士认为具有更精细功能尺寸的SOC现在也将继续存在,但芯片设计和异构集成封装提供了SOC的替代方案,特别是针对高级节点。芯片异构集成在产品产量、上市时间、设计成本、热性能和IP利用率以及模块化方面显然更具优势。
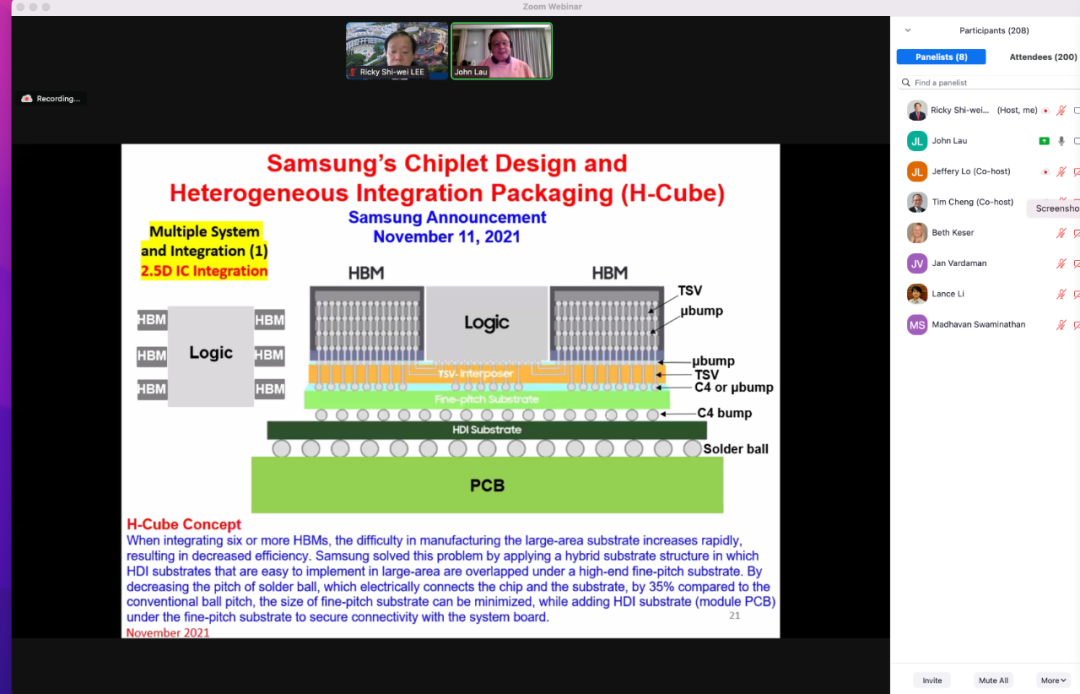
最后的问答与交流环节,直播间听众们纷纷提出了他们对于“系统级封装和异构集成”等一系列问题,与专家深入探讨,气氛热烈。

随着“中国制造2025”、“粤港澳大湾区”、“新一代人工智能发展规划”等国家战略出台和一系列政策积极推进,粤港澳大湾区近年来积极谋划新一代人工智能产业在时间和空间上的系统性战略布局,相关产业得到快速发展,前景非常看好。与会大咖们就3D IC与异构集成问题如功率、线路、讯号等前沿技术进行了深入探讨,并一致认为3D IC与异构集成技术将会成为影响未来系统设计的核心技术,具有广阔的商业前景。显然,当旧技术不再满足新的生产关系,技术的革新往往也是社会检视、改变、进步的重要机遇,后摩尔定律时代,港科大会将继续在未来联同各国际伙伴举办各式各样的交流活动,在科研、学术交流、知识传播等领域通力合作,共同为满足社会需要、增加社会福祉而努力。本次研讨会在3小时的直播时间里,共吸引全球行业精英共超千人上线参与,四位科技精英深度剖析,为行业带来一场思想的“盛宴”,最后研讨会圆满结束。
-
请填写相关信息










